商机详情 -
原装膜厚仪技术指导
在纳米级薄膜的各项相关参数中,薄膜材料的厚度是薄膜设计和制备过程中重要的参量之一,具有决定薄膜性质和性能的基本作用。然而,由于其极小尺寸及突出的表面效应,使得对纳米级薄膜的厚度准确测量变得困难。经过众多科研技术人员的探索和研究,新的薄膜厚度测量理论和测量技术不断涌现,测量方法从手动到自动、有损到无损不断得到实现。对于不同性质薄膜,其适用的厚度测量方案也不相同。针对纳米级薄膜,应用光学原理的测量技术。相比其他方法,光学测量方法具有精度高、速度快、无损测量等优势,成为主要检测手段。其中代表性的测量方法有椭圆偏振法、干涉法、光谱法、棱镜耦合法等。白光干涉膜厚测量技术可以实现对薄膜的在线检测和控制;原装膜厚仪技术指导

在激光惯性约束核聚变实验中,靶丸的物性参数和几何参数对靶丸制备工艺改进和仿真模拟核聚变实验过程至关重要。然而,如何对靶丸多个参数进行同步、高精度、无损的综合检测是激光惯性约束核聚变实验中的关键问题。虽然已有多种薄膜厚度及折射率的测量方法,但仍然无法满足激光核聚变技术对靶丸参数测量的高要求。此外,靶丸的参数测量存在以下问题:不能对靶丸进行破坏性切割测量,否则被破坏的靶丸无法用于后续工艺处理或打靶实验;需要同时测得靶丸的多个参数,因为不同参数的单独测量无法提供靶丸制备和核聚变反应过程中发生的结构变化的现象和规律,并且效率低下、没有统一的测量标准。由于靶丸属于自支撑球形薄膜结构,曲面应力大、难以展平,因此靶丸与基底不能完全贴合,可在微观区域内视作类薄膜结构。防水膜厚仪零售价格随着技术的不断进步和应用领域的扩展,白光干涉膜厚仪的性能和功能将得到进一步提高;

白光干涉的相干原理早在1975年就被提出,并在1976年实现了在光纤通信领域中的应用。1983年,Brian Culshaw的研究小组报道了白光干涉技术在光纤传感领域中的应用。随后在1984年,报道了基于白光干涉原理的完整的位移传感系统。这项研究成果证明了白光干涉技术可以用于测量能够转换成位移的物理参量。此后的几年中,白光干涉技术应用于温度、压力等的研究也相继被报道。自上世纪90年代以来,白光干涉技术得到了快速发展,提供了更多实现测量的解决方案。近年来,由于传感器设计和研制的进步,信号处理的新方案提出,以及传感器的多路复用等技术的发展,使白光干涉测量技术的发展更加迅速。
薄膜在现代光学、电子、医疗、能源和建材等技术领域得到广泛应用,可以提高器件性能。但是由于薄膜制备工艺和生产环境等因素的影响,成品薄膜存在厚度分布不均和表面粗糙度大等问题,导致其光学和物理性能无法达到设计要求,严重影响其性能和应用。因此,需要开发出精度高、体积小、稳定性好的测量系统以满足微米级工业薄膜的在线检测需求。当前的光学薄膜测厚方法无法同时兼顾高精度、轻小体积和合理的成本,而具有纳米级测量分辨率的商用薄膜测厚仪器价格昂贵、体积大,无法满足工业生产现场的在线测量需求。因此,提出了一种基于反射光谱原理的高精度工业薄膜厚度测量解决方案,研发了小型化、低成本的薄膜厚度测量系统,并提出了一种无需标定样品的高效稳定的膜厚计算算法。该系统可以实现微米级工业薄膜的厚度测量。白光干涉膜厚仪需要校准。
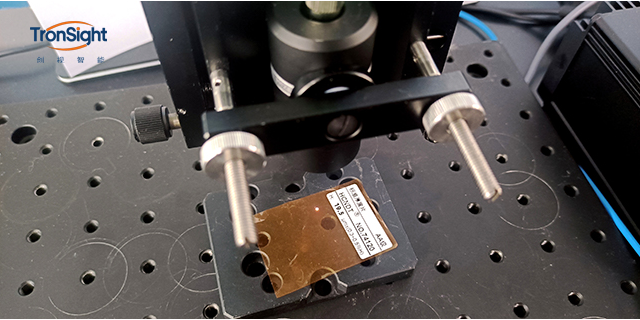
干涉法与分光光度法都是利用相干光形成等厚干涉条纹的原理来确定薄膜厚度和折射率 ,然而与薄膜自发产生的等倾干涉不同,干涉法是通过设置参考光路,形成与测量光路间的干涉条纹,因此其相位信息包含两个部分,分别是由参考平面和测量平面间扫描高度引起的附加相位和由透明薄膜内部多次反射引起的膜厚相位。干涉法测量光路使用面阵CCD接收参考平面和测量平面间相干波面的干涉光强分布,不同于以上三种点测量方式,可一次性生成薄膜待测区域的表面形貌信息,但同时由于存在大量轴向扫描和数据解算,完成单次测量的时间相对较长。当光路长度增加,仪器的分辨率越高,也越容易受到静态振动等干扰因素的影响,需采取一些减小噪声的措施。苏州膜厚仪找哪家
通过测量反射光的干涉来计算膜层厚度,利用膜层与底材的反射率和相位差来实现测量。原装膜厚仪技术指导
基于白光干涉光谱单峰值波长移动的锗膜厚度测量方案研究 :在对比研究目前常用的白光干涉测量方案的基础上,我们发现当两干涉光束的光程差非常小导致其干涉光谱只有一个干涉峰时,常用的基于两相邻干涉峰间距的解调方案不再适用。为此,我们提出了适用于极小光程差的基于干涉光谱单峰值波长移动的测量方案。干涉光谱的峰值波长会随着光程差的增大出现周期性的红移和蓝移,当光程差在较小范围内变化时,峰值波长的移动与光程差成正比。根据这一原理,搭建了光纤白光干涉温度传感系统对这一测量解调方案进行验证,得到了光纤端面半导体锗薄膜的厚度。实验结果显示锗膜的厚度为,与台阶仪测量结果存在,这是因为薄膜表面本身并不光滑,台阶仪的测量结果只能作为参考值。锗膜厚度测量误差主要来自光源的波长漂移和温度控制误差。原装膜厚仪技术指导